原子力显微镜(AFM)已经从分辨率极高的科研仪器进入一个高度精确的计量工具。这种演变扩大了AFM的角色从研究台工业场所。需要检查的收缩几何图形的半导体芯片制造过程中涉及互联,光学成像系统的扩展的nanotechnical领域AFM是合乎逻辑的。 原子力显微镜(AFM)表面感应AFM雇佣了一个系统的传感自动锋利的硅探测器之间的极其微小的差异和表面接受调查。这种敏感性是至关重要的监视和测量纳米大小的表面细节。 光学系统能够识别特性感兴趣的大约1微米的分离,但无法作出准确的测量功能,或告诉如果一个粒子或草皮。 半导体缺陷检测图1显示了一个AFM尖端指向一个未知功能的半导体IC。表面AFM能够跟踪和识别可能的缺陷。 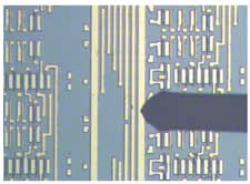
图1所示。AFM尖端指向一个未知功能的半导体集成电路。 图2。在最初的扫描显示了AFM探针覆盖感兴趣的区域如图1所示。可以看到激光反射的悬臂传感器准确地把探头放在正确的垂直位置。 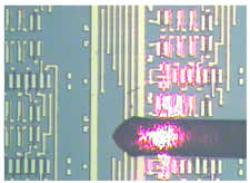
图2。AFM探针在其初始扫描覆盖感兴趣的区域。 一个缺陷在一条线的边缘IC电路如图3所示。黑暗的颜色是放在最低的部分样本深度,而鲜艳的颜色被放置在地形的最高点。 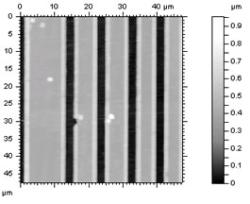
图3。一个缺陷在一条线的边缘IC电路。 图4中的谱线轮廓分析显示显示垂直维度沿着一个选择从512年在扫描线扫描。 
图4。谱线轮廓的分析。 减少扫描感兴趣的小面积的“缩放”如图5所示。黑暗的特点和产生的谱线轮廓截面报告,有少量的材料缺少金属线。 
图5。小面积的减少扫描“缩放”的兴趣。 测量,用于计算的体积和面积丢失特性估计数量的物质损失,可能会发现在生产过程污染是图6所示。缺陷的面积大约是2.05哦2和材料的体积可能会丢失的是0.134哦3。 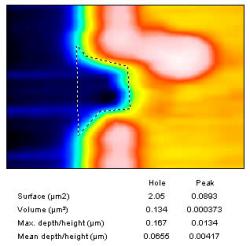
图6。测量用于计算体积和面积丢失的特性来估计数量的物质损失,可能会发现在生产过程的污染。 三维重建的多个单行概要AFM图7所示。缺点是清晰可见的色彩增强和集成电路互连线的旋转表示。缺少一些材料表面的缺陷可能会堆积,见红超过撞左边的半月状切口线边缘。 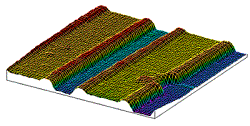
图7。三维重建的多个单行概要AFM。缺点是清晰可见的色彩增强和集成电路互连线的旋转表示。 快速的组合光学检验和AFM的能力做出快速而准确的测量有助于解决和消除问题在纳米领域。 |